景碩願景
成為世界級載板製造及技術領先廠商
台灣的半導體產業除了擁有核心優勢的人才、技術外,最重要的是要構建完整的產業供應鏈,而隨著最近年來IC封裝逐漸為BGA、CSP,甚至是Flip-Chip所取代,成為封裝主流的趨勢下,景碩科技在封裝載板研發及製造技術上的投注,已成為技術領先的優勢,其中包含細線路、薄厚度、複雜結構等技術,結合對市場發展及需求的敏銳觸角,逐漸形成整體領先同業的優勢能力。
台灣的半導體產業除了擁有核心優勢的人才、技術外,最重要的是要構建完整的產業供應鏈,而隨著最近年來IC封裝逐漸為BGA、CSP,甚至是Flip-Chip所取代,成為封裝主流的趨勢下,景碩科技在封裝載板研發及製造技術上的投注,已成為技術領先的優勢,其中包含細線路、薄厚度、複雜結構等技術,結合對市場發展及需求的敏銳觸角,逐漸形成整體領先同業的優勢能力。

Description
系統級封裝為一個系統平台,將多個異質晶片、感測元件、被動元件等等組裝在一個封裝之內。其應用包括"多晶片模組(MCM)"、"多晶片封裝(MCP)"、"堆疊晶片封裝"、"封裝內包封裝(PiP)"、及"內埋元件載板"等。 系統級封裝為IC系統設計者提供了除了"系統級晶片(SoC)"之外的另一個運算功能整合方案,它具備有整合不同來源的異質晶片、較小較薄、快速進入市場等優勢。
Applications
Features

Description
這是應用於打線封裝最基礎的球閘陣列載板,它的基礎材料為樹脂含浸玻璃纖維的銅箔基板。塑膠球閘陣列封裝基板可應用於相當高腳數的晶片封裝。當晶片功能升級時,通常伴隨輸出/輸入腳數的增加,傳統的導線架封裝結構變得不敷使用,塑膠球閘陣列封裝基板便提供了一個高性價比的解決方案。
Applications
Features
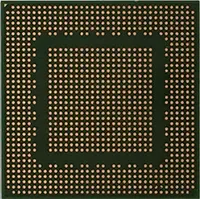
Description
智慧型手機現今已成為人人持有的裝置,其需求的強大運算能力與網路接取能力,在在都驅使IC功能及腳數快速的增加。當晶片輸出/輸入腳數持續增高之際,覆晶晶片級尺寸封裝便益加顯示成本優勢。近期以來,晶片上的凸塊的製程成本也持續下降,這也促使封裝成本更快速的降低。今日,覆晶晶片級尺寸封裝已成了高腳數IC,例如手持式裝置應用處理器,的主流封裝技術。
Applications
Features

Description
輕薄短小一直是各式手持式裝置發展的趨勢,它驅使了組件及零件的小型化。更薄及更小的IC封裝變成了手持式裝置零組件的基本技術需求。晶片尺寸級封裝在這些需求下,便成了手持式裝置內部零組件最主流的封裝技術。
Applications
Features
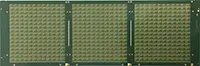
Description
無數多樣化的雲端應用程式、多采多姿的多媒體內容,已成了數位時代生活的重點內容。這類的需求需要極大的通訊頻寬,當然也增加了許多手機通訊頻段的需求。為因應未來人類生活中的通訊需求,頻段整合及推出更先進的通訊協定就會一直的進行。在手持式裝置或雲端裝置上呈現出的,就是更多的功率放大器及前段射頻模組。射頻模組封裝載板與多數的數位線路設計略有不同,它需要更高的設計經驗與技巧,同時需求更嚴謹的製程控制。
Applications
Features

Description
在非常高輸出/輸入腳數,例如微處理器或圖像處理器之類的晶片的封裝上,覆晶球閘陣列封裝就有非常優異的性能及成本優勢。在這類數千個接腳數的晶片的封裝上,打線封裝技術幾乎不可能同時在性能及成本兩方面與覆晶封裝技術抗衡。在雲端科技的各式應用領域裡,伺服器及資料中心的需求無所不在,它們都需要具備強大的運算功能,晶片的接腳數也不斷的提高,覆晶球閘陣列封裝已經成為主流技術。
Applications
Features