基本情報
熱解離膠帶是一種具備可控溫剝離特性的高性能膠帶,廣泛應用於半導體製程、電子元件加工、光電產業及精密模具製造等領域。其獨特的設計可在特定溫度條件下迅速失去黏性,使膠帶在完成加工後能夠快速、無殘膠地剝離,大幅提升製程效率與產品良率。
概要
熱解離膠帶產品外觀圖
這張圖展示了一卷熱解離膠帶的產品外觀。膠帶從白色內芯捲筒中拉出,可以清楚看到其雙層結構:
上層為光滑、半透明的淡褐白色表面材(如 PET 或 PI 基材)
下層為深色、不透明的黏著層(熱可釋放膠)
產品特點
熱剝離設計
膠帶於設定溫度(常見為120°C~150°C)時失去黏性,實現快速分離。
高潔淨性
無殘膠、不留痕跡,保持產品表面潔淨,適合高精密應用。
強固黏著力
加工前可穩固貼合產品,避免移位,提升操作穩定性。
支援多種基材
提供PET、PI等不同基材類型,可依需求選擇適用規格。
耐熱穩定性佳
膠帶在高溫過程中不變形、不起泡,確保加工品質。
主要應用領域
晶片研磨(Wafer Grinding)
用於晶圓背面研磨製程中固定晶片,穩定支撐防止破裂,完成後可透過加熱方式無損剝離,適用於先進封裝或薄型晶圓製程。
壓模製程(Molding Process)
於精密壓模或複合材料壓合工序中,熱解離膠帶可暫時固定模內物件,加熱剝離後不損模具表面,延長模具壽命。
精密雷射切割、打孔
避免工件位移,提升切割精度與良率,加熱後移除不留殘膠,適合光學或電子薄膜製品製程。
光學面板與觸控元件保護
在組裝與搬運階段暫時性固定光學元件,剝離後不影響透光率與貼合品質。
應用流程圖
晶圓研磨應用流程圖(Wafer Grinding Application)
晶片研磨(Wafer Grinding)
晶圓貼附於熱解離膠帶上,膠帶下方為承載載體(Carrier),上方進行研磨作業。
→ 圖中紅色箭頭表示研磨方向。
加熱(Heating)
完成研磨後,從下方或上方加熱膠帶至設定溫度(如120°C~150°C),膠帶黏性逐漸消失。
→ 圖中紅色波紋線表示加熱過程。
膠帶移除(Tape Removal)
加熱完成後,膠帶可輕鬆從晶圓與載體間剝離,且無殘膠,確保晶片表面潔淨無損。
→ 圖中藍色箭頭顯示膠帶剝離方向。
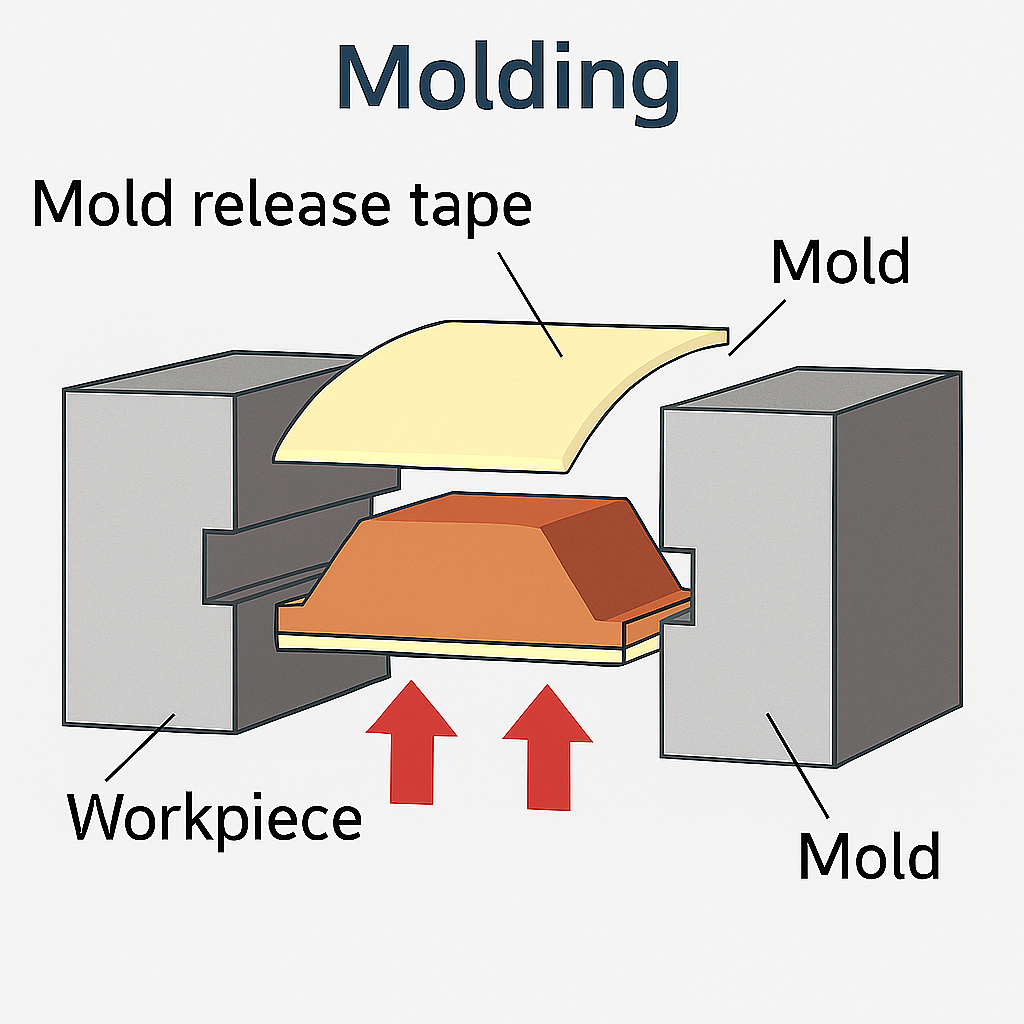
壓模應用示意圖(Molding Application)
Mold(模具)
模具分為上下兩半,為工件成型提供壓力與形狀空間。
Workpiece(工件)
工件放置於模具下半部,準備進行壓模。
Mold release tape(熱解離膠帶)
位於工件與模具之間,用以暫時固定工件並防止工件與模具直接接觸,加熱後膠帶會失去黏性,能快速剝離。
紅色箭頭
表示壓模加壓方向,模具閉合進行加壓成型。

熱解離剝離機制圖(Heat Release Mechanism)
加熱階段(左側)
下方紅色波紋代表熱能傳遞至膠帶底部。
膠帶上方貼有被固定的物體(Upper Substrate)。
加熱後膠帶失去黏性,開始鬆脫。
膠帶剝離階段(右側)
加熱完成後,膠帶可輕鬆從基材上剝離。
圖中藍色箭頭表示膠帶撕除方向。
展現出乾淨分離、不留殘膠的效果。
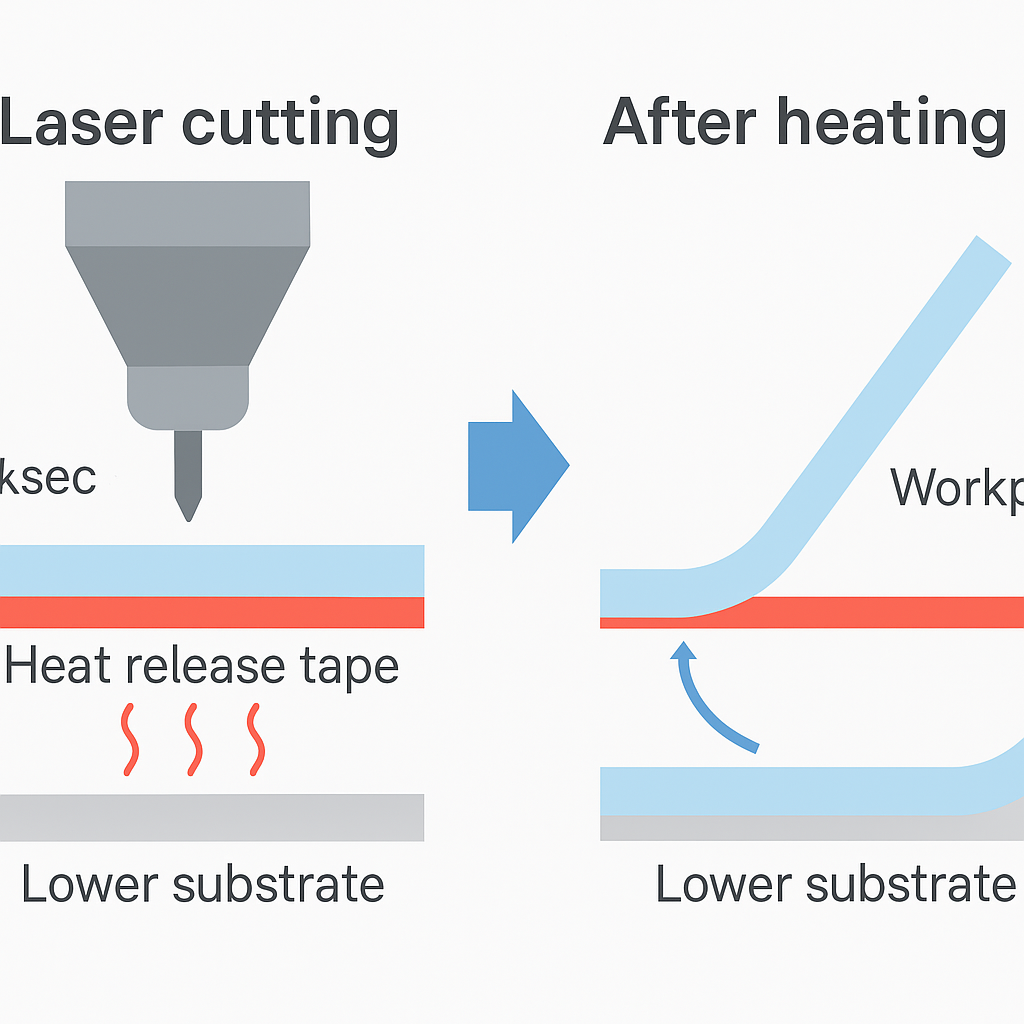
雷射切割應用圖(Laser Cutting Application)
「Laser cutting」雷射加工階段(左側)
一層藍色的工件(Workpiece)經由熱解離膠帶(紅色)貼附於下方基材(Lower substrate)上。
雷射切割機自上方垂直加工。
同時下方標示紅色熱波紋,顯示製程中伴隨加熱作業。
「After heating」剝離階段(右側)
經加熱後,熱解離膠帶失去黏性。
工件可輕鬆從下層剝離,藍色箭頭表示剝離方向。
無殘膠、不破壞切割線,保持工件精度。
光電面板貼合應用圖(Optical Panel Bonding)
上方視角:結構示意
一組光電面板(Optical Panel)被疊合於底層基板之上。
中間夾有紅色的熱解離膠帶(Heat release tape),提供臨時固定功能。
圖中藍色箭頭顯示面板下壓組裝方向。
下方視角:分層剖面圖
最上層:光學面板
中間層:熱解離膠帶(紅色,標示有黏著層)
底層:基板或加工載體
觸控面板、偏光片、導光板等組裝過程中,提供臨時固定且無殘膠的好處。